

For many of today’s advanced materials, transmission electron microscopy (TEM) is the best technique for gathering valuable information about microstructure and properties. Because features in nanotechnology research and semiconductor device specimens continue to decrease in size, it is essential that specimens be very thin and free of preparation-induced artifacts. These requirements are even more important when using TEMs with aberration correction and monochromated electron sources where resolution is sub-Ångström.
The NanoMill system uses an ultra-low energy, concentrated ion beam to produce the highest quality specimens for transmission electron microscopy.
Ultra-low-energy, inert-gas ion source
Concentrated ion beam with scanning capabilities
Removes damaged layers without redeposition
Ideal for post-focused ion beam processing
Enhances the results from conventionally prepared specimens
Room temperature to cryogenically cooled NanoMillingSM process
Rapid specimen exchange for high-throughput applications
Computer-controlled, fully programmable, and easy to use
Contamination-free, dry vacuum system
-

-

-

-

-

-

-

-

-

-

-

-

-
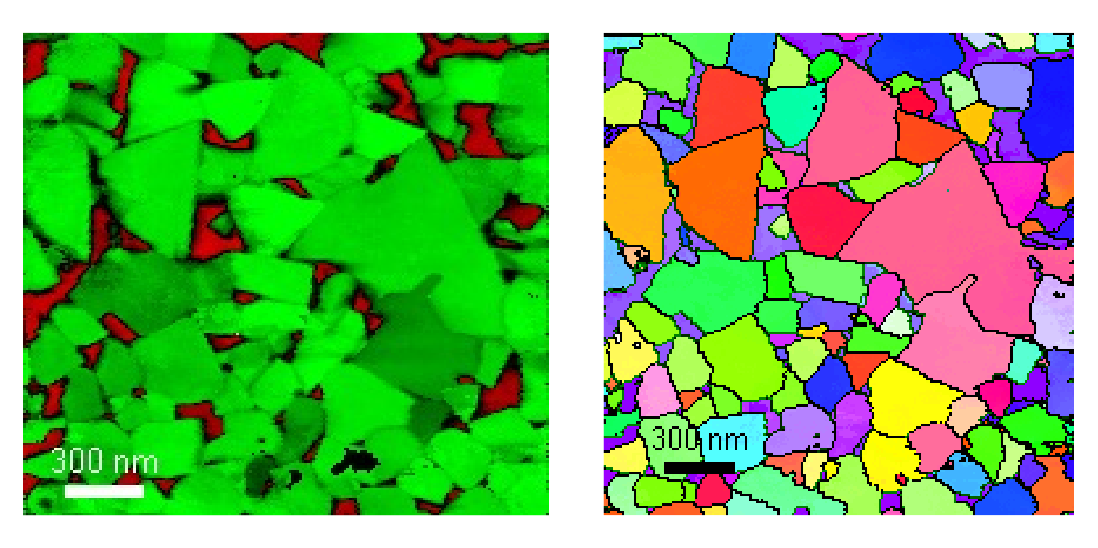
-
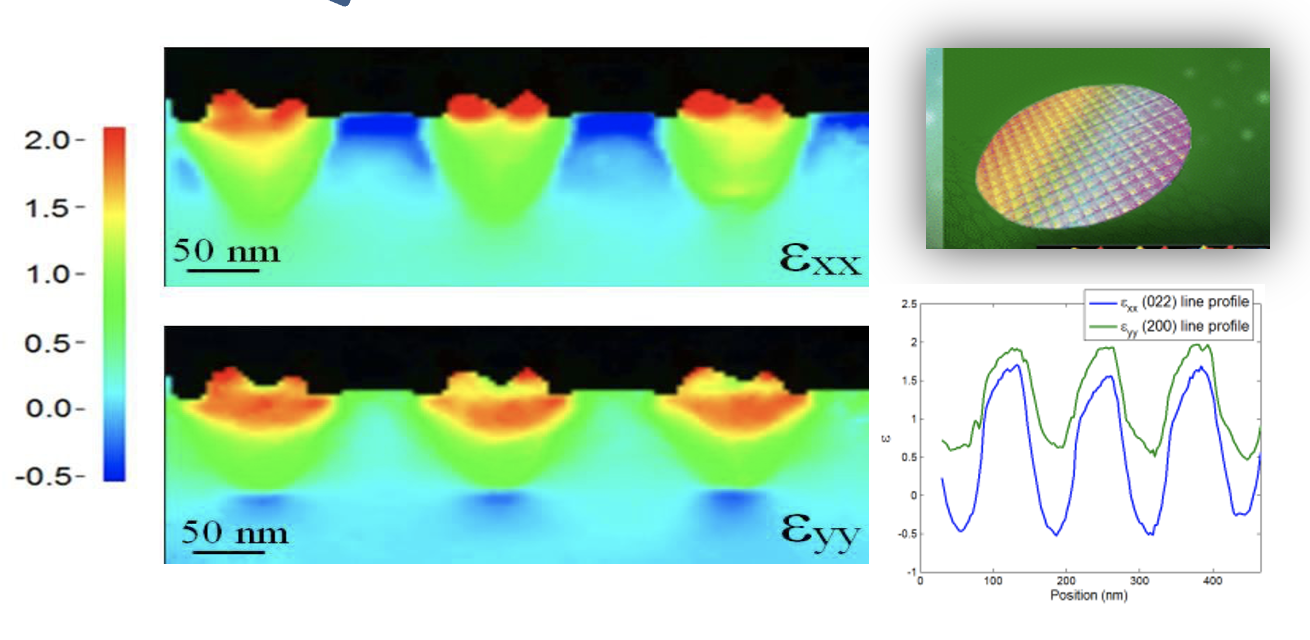
-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-
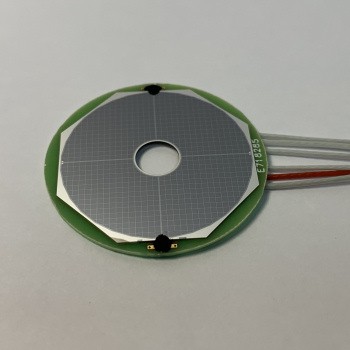
-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-

-
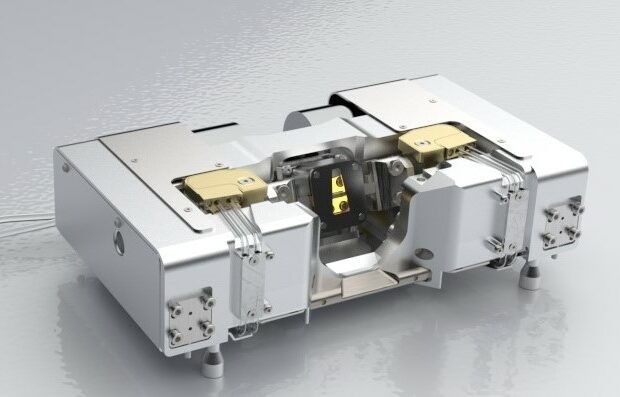
-

-

-
-
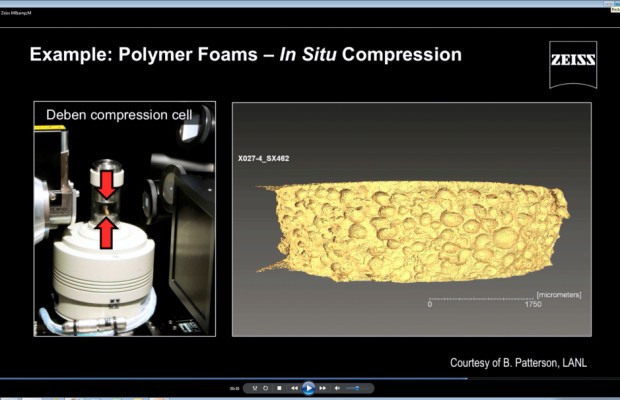
-
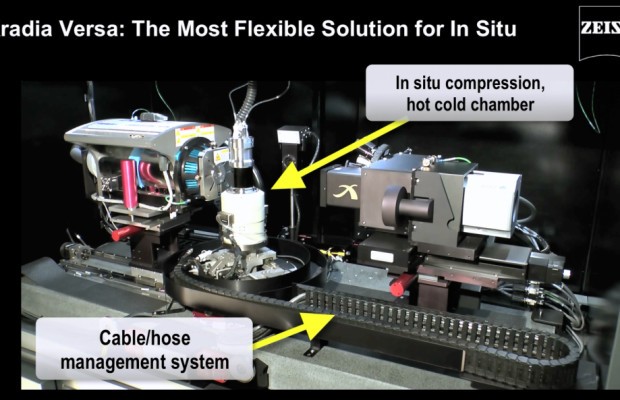
-

-

-

-

-

-

-

-

-

-

-

-



